Accelerating Root Cause Identification of Subtle Bonding Failures Using MIP

Texas Instruments, ECTC 2025, Cu Bond Wire, Reliability Test.
Optimizations and Case Studies—Decapsulation of Hardened Epoxy SiC MOSFETs and Diodes via JIACO Microwave Induced Plasma Etching
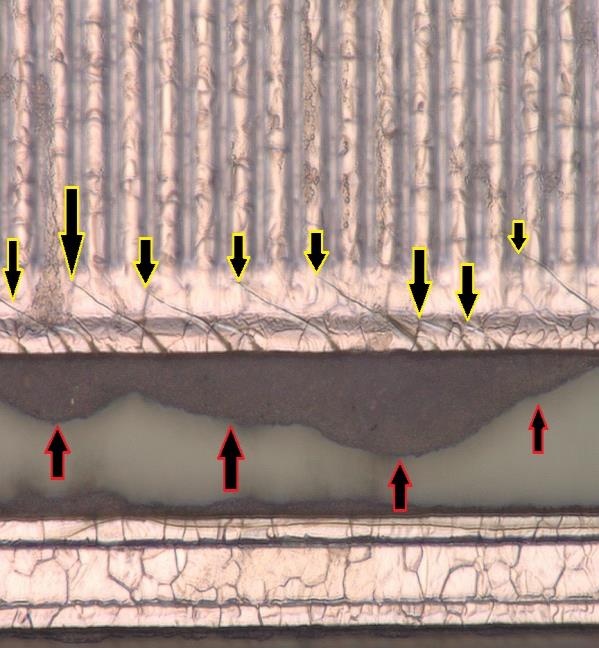
Microchip Technologies, ISTFA 2024, High Tg Mold Compound, Passivation & Die Crack, SiC, Reliability Test.
Improving the Wire Bond Pull Test and FA for Copper Wired Components

Eurofins Maser, AEC Workshop 2024, Cu Bond Wire, AEC Q100 & Q006 Qualification, Reliability Test.
Aluminium corrosion in power semiconductor devices
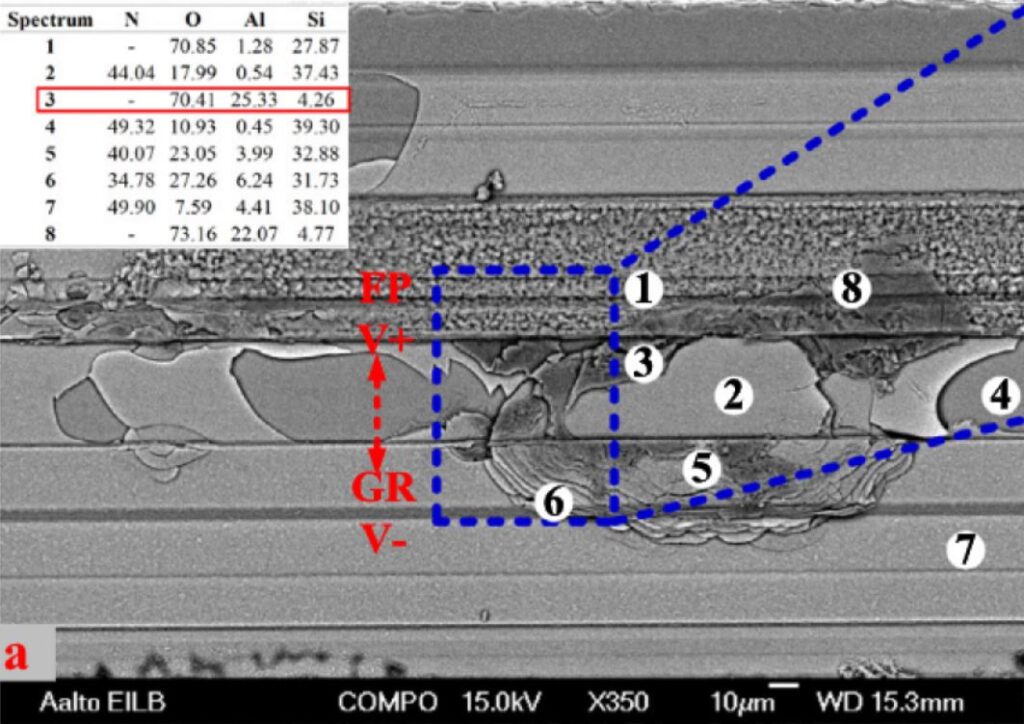
ABB, Journal Microelectronics Reliability 2022, Corrosion, Migration & Bridging, Reliability Test.
Preserving Evidence for Root Cause Investigations with Halogen-Free Microwave Induced Plasma
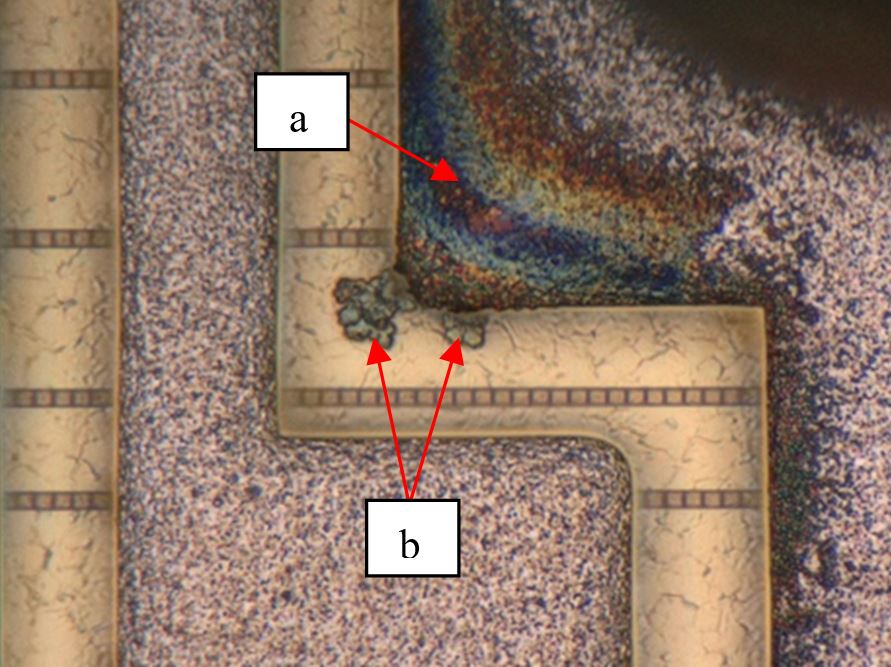
Texas Instruments, ISTFA 2018, BOAC, Cu Bond Wire, Migration & Bridging, Reliability Test, Contamination, Corrosion.
Decapsulation of copper wire devices with high Tg mold compound using microwave induced plasma
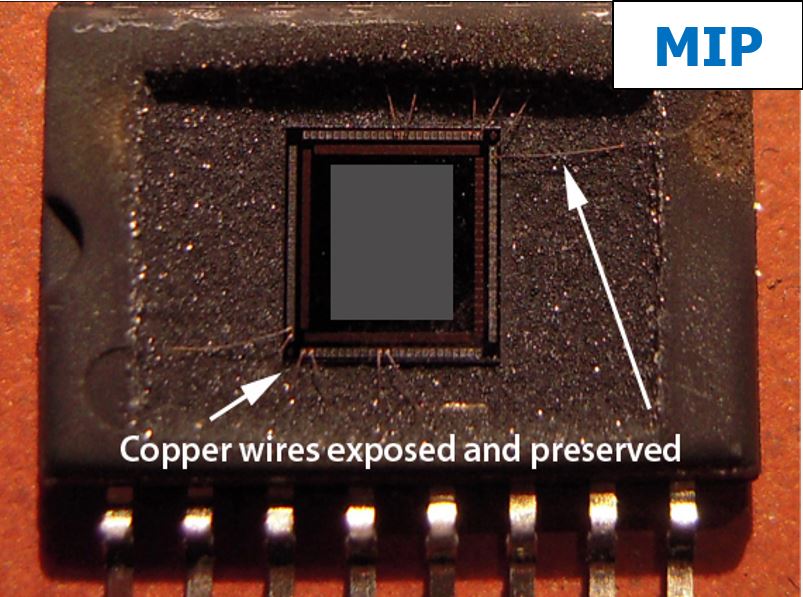
Sumitomo Bakelite, IPFA 2016, High Tg Mold Compound, Cu Bond Wire, Reliability Test.
